以碳化硅(SiC)、氮化镓(GaN)等为代表的第三代半导体正在快速发展,在新一代电子器件、通信、交通及新能源等领域有着重要的应用前景,其关乎国内工业体系的安全和长远发展,也是各国争先发展的战略高地[1]。我国半导体关键器件长期依赖进口,尤其是高性能芯片的设计与制造能力有待提高。半导体工业作为国家战略支柱产业,其安全与自主可控是影响我国经济社会发展的基础和关键。集成电路是半导体芯片的关键部件,是电子信息产业的核心,是第六代移动通信技术、人工智能等先进技术的基础和关键。集成电路性能的提升依赖于工艺和材料的创新,难熔金属靶材是制备集成电路的关键材料,通过提高纯度、调控微观组织、完善性能检测评价可促进国内集成电路产业的高质量发展和制备能力增长[2-3]。

我国在难熔金属材料领域具有较好的产业规模优势,但满足高端集成电路用的高纯难熔金属靶材的发展仍然滞后于芯片器件的需求。如表1所示,集成电路用的难熔金属靶材主要有高纯钨、钨合金靶材以及高纯钽靶材等[4-6],主要用于晶圆制造和芯片封装等领域。半导体及关键材料的制备与性能影响着我国高端芯片产业的发展,为了更好地满足国内半导体产业用难熔金属靶材的需求,提高核心制备技术和创新能力,本文分析了近几年导体用难熔金属靶材的研究现状,介绍了半导体领域用难熔金属靶材的科研成果和关键技术,并对半导体用难容金属靶材升温技术的发展趋势进行了展望。

1、高纯钨靶材
钨具有优良的导热、导电性能,电阻率低,高温性能稳定,可用作半导体中的通孔、导线以及硅铝之间的隔离层。随着半导体尺寸越来越小,精度要求越来越高,对于钨靶材的纯度、相对密度、织构调控和细晶组织等性能提出了更高的要求[7-9]。
钨薄膜的纯度决定于钨靶的纯度,钨靶材中氧含量过高,易在沉积薄膜中形成微粒,造成电路短路。钨靶材中的K、Na等元素会增加薄膜的电阻率,影响电子迁移速率,还会扩散进入二氧化硅的绝缘层中形成泄露,造成器件失效。因此,钨靶的纯度一般要求≥99.999%(5N)以及更高。钨靶的制备工艺为粉末冶金方法,相对密度低的坯料中的孔洞会在薄膜溅射过程中产生微粒或不均匀冲蚀现象,提高了电阻率,降低了器件的良品率。提高钨靶材的相对密度则可以加快薄膜沉积速率,降低薄膜应力和取向差,进而提升靶材的溅射效率[7]。
半导体行业中钨靶的相对密度一般要求≥99.5%,致密性越高,电阻率越低。
钨板靶材一般需要经过轧制变形,获得需要的产品尺寸和性能。但轧制变形会在钨内部形成晶粒择优取向或织构,进而影响薄膜厚度均匀性和电阻率稳定性,强烈的织构会造成薄膜厚度异常和良品率急剧降低。为了满足芯片的要求,钨靶不应存在强烈的织构,在厚度方向的晶粒取向应基本均匀,从而保证钨靶材的质量一致性和批次稳定性。溅射靶材的晶粒尺寸常规要求≤100μm,晶粒大小均匀,均匀细晶的靶材溅射沉积速率和膜的均匀性能优于大晶粒。但高纯钨内杂质元素很少,无法阻止晶粒长大,且高纯钨晶粒再结晶成核率低,钨晶粒细化困难,因此高纯钨的晶粒细化和均匀化是半导体用钨靶材的关键技术。
钨靶材的形状有圆形、条形等,如图1所示。半导体用高纯钨的利润率较高,制备工艺是各家单位的关键技术,公开的技术资料较少,主要通过将高纯钨粉冷压成形和高温烧结得到相对密度≥95%的坯料,再进行轧制变形和热处理,最终获得满足要求的纯钨靶材产品。

粉末冶金+轧制变形的工艺方法可实现批量化生产,工艺参数可调整性强,可制备出不同性能要求的钨靶产品,但轧制时晶粒尺寸控制和织构调控是难点和关键技术。Yu等[8]开发了一种高纯钨粉的制备工艺,以低U/Th比的仲钨酸铵(APT)为原料,经多重结晶获得高纯APT,再经H2还原制备6N级高纯钨粉,最后利用6N钨粉制备出了高纯的钨板和钨产品。
2、钨合金靶材
2.1钨钛合金靶材
在钨中添加质量分数10%钛制成钨钛合金,可以综合利用钨的高原子量与钛的高耐腐蚀性,钨钛合金溅射形成的薄膜层可以防止外来原子扩散,常用做芯片的扩散阻挡层和粘结层。钨钛合金电子迁移率低、热力学性能稳定、抗腐蚀性能优良以及化学稳定性好,也被应用于太阳能等领域。
钨钛合金靶材主要通过热压烧结的工艺制备,以钛粉和氢化钛粉作为钛源,将均匀混合的钨粉与钛粉致密化,得到高性能的钨钛合金靶材。于洋等[9]和姚力军等[10]以钨粉、氢化钛粉及部分钛粉为原料,经真空热压制备了钨钛合金坯料,通过设置加压速度,使钨钛合金在高温高压迅速收缩,退火后得到相对密度99%以上钨钛靶材。曲选辉等[11]通过提纯仲钨酸铵和氢气还原制备高纯钨粉,与TiH2粉混合后进行多阶段真空热压烧结,该方法具有粉末纯化、烧结纯化以及过程纯化等特点,制备的钨钛合金靶材纯度可达99.999%以上。金钟玲等[12]研究表明,W-TiH2混合粉末经球磨后颗粒中位径达到1.31μm,只有W-Ti混合粉末中位径(13.01μm)的10%,其粒度分布如图2所示。相比于纯Ti,W-TiH2混合粉末中TiH2分解与W形成固溶体并细化为纳米级颗粒,更易得到均匀细小的烧结晶粒组织。W粉颗粒会促进TiH2粉末的破碎,使粉末粒度变小,但不能对粗而软的Ti粉起破碎作用,反而会嵌在Ti粉上使颗粒粒度变大。

杨益航等[13]研究分析了钨钛合金中钛的来源,即TiH2的变化,通过热压成形工艺制备出了纯度99.9993%的超高纯WTi10靶材制品,图3为制备的钨钛合金粉末形貌。相比于纯Ti,由TiH2高温分解烧结制备的WTi合金气体杂质含量较低,微观组织更均匀,形成纤维状富钨相β(W,Ti)倾向减弱。郭让民等[14]研究了加压方式对真空热压钨钛合金烧结性能的影响,结果表明,在相同温度条件下施加高预压力得到的烧结密度较高,致密化过程较快。崔明培等[15]采用变压和等离子放电与直流电双模式组合烧结的方式制备出相对密度≥99.98%、微观组织均匀可控的钨钛合金靶材,烧结时间短、效率高。杨益航等[16]研究表明,WTi10合金的密度随烧结温度升高而增大,温度高于1250℃时生成完全固溶的体心立方β相,主要包含W、富钨β(W,Ti)及富钛β1(W,Ti)三种相组成。富钨相和富钛相均会对钨钛合金靶材的性能产生不利影响,建议加工温度应该在1400~1500℃,加压压力不小于15MPa。图4为温度1500℃,压力25MPa,保压60min制备的钨钛合金元素面分布。

除了真空热压工艺外,还可通过热等静压[1718]及高温真空烧结[19]工艺制备高纯钨钛合金靶材。将钨粉和TiH2粉混合压制成形,经预烧将TiH2还原,再经高温真空烧结得到合金坯料,将坯料带包套进行热轧,最终得到相对密度99.6%以上的尺寸可控钨钛合金靶材。
2.2钨硅合金靶材
钨硅合金(WSi)溅射薄膜在半导体电路中与硅有着良好的接触界面,被广泛使用在动态随机存储器中的栅极接触层和扩散阻挡层中,具有高导电率、耐高温、抗化学腐蚀等特点[20]。黄志民等[21]以真空煅烧制备钨硅合金块体,再经破碎和烧结致密化制备钨硅合金靶材,如图5所示。高温煅烧可以显著降低材料的C、O含量。通过1250℃煅烧5h,氧含量(质量分数)可由0.3000%降至0.0121%,材料中的单质钨完全转化为钨硅合金相。
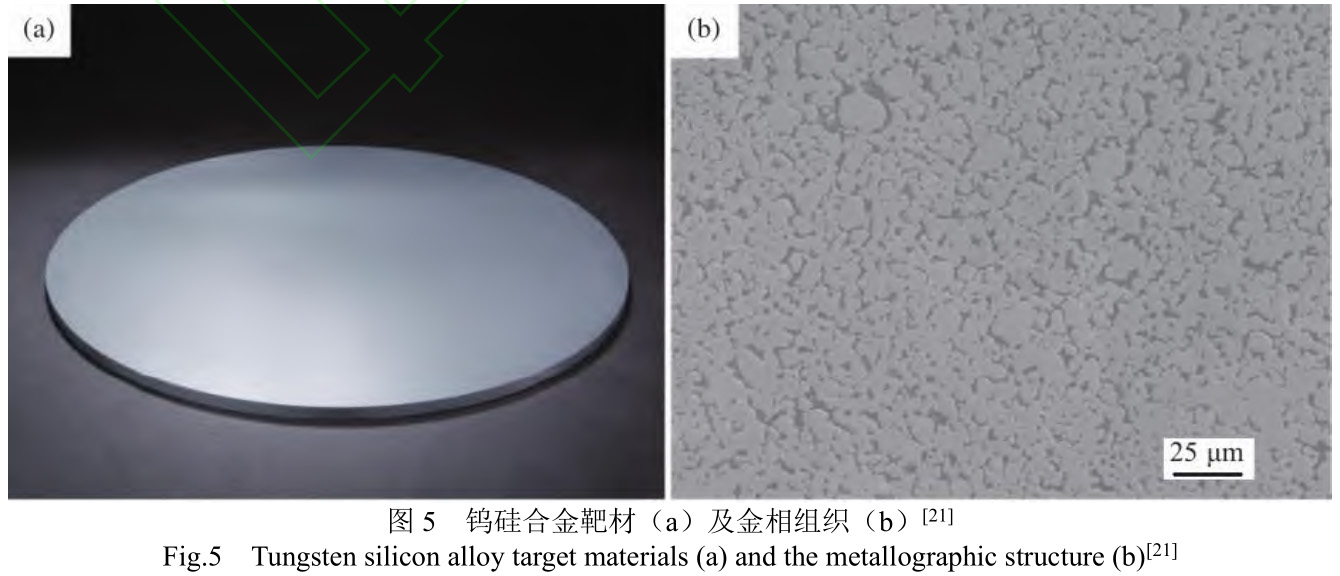
钨硅合金靶材制备技术要求高,具有较好的市场前景,很多厂家通过专利公开了新的制备技术。张龙辉等[22]使用高纯钨粉和硅粉,混合后经过高温烧结得到合金粉末团聚体,经过破碎处理,制备出分散性较好的高纯钨硅粉,碳含量(质量分数)≤100×10-6,氧含量(质量分数)≤300×10-6。姚力军等[23]通过高能球磨将钨粉和硅粉混合,结合特定的烧结过程,提升了钨硅合金靶材溅射膜的均匀性能。李利利等[24]以高纯度的钨粉和硅粉为原料,在惰性气氛下进行粉末配料和混合,使用热等静压制备出相对密度≥99%、纯度≥5N、氧含量(质量分数)≤400×10-6的钨硅靶材。程少磊等[25]将硅粉经真空加热和水淬处理,通过真空球磨干燥后加入到硫酸和盐酸的混合液进行超声处理,将得到的硅粉与钨粉经球磨混合后进行真空感应加热初步合金化,再将粉体进行球磨、烧结和机加工,得到钨硅合金靶材,该工艺可以提高靶材的相对密度和均匀性,避免在镀膜过程中的污染,降低薄层不均一性。
3、高纯钽靶材
随着半导体集成电路制造技术的突飞猛进,Cu已成为全球高端电子器件的布线材料,Ta作为Cu的互连阻挡层材料得到了迅速发展。Ta具有较高的熔点、高热稳定性和高导电性,Ta和Cu之间不反应,不扩散形成化合物,Ta膜可防止铜向硅基底扩散。钽溅射薄膜可作为集成电路封装中铜层外侧的阻挡层,还可用于制备高介电栅介质层的氧化物薄膜,有助于缩小晶体管的尺寸,改善晶体管的驱动性能。钽还可以被制作成溅射钽环件,用来约束聚焦溅射粒子的运动轨迹以及吸附、净化溅射过程中产生的大颗粒。
在半导体用靶材市场上,钽靶材制备技术难度最高,市场占比也最高,需要严格控制钽靶的晶粒尺寸和织构取向,保证晶粒均匀分布。很长时间以来,我国生产溅射钽靶材用的高纯Ta原料主要依赖进口,在高纯度钽靶材的制备技术尤其是组织均匀性控制及取向分布等方面与国外存在差距,导致溅射薄膜均匀性不稳定。在国家政策引导和资金支持下,国内企业在高纯钽提纯及靶材制备等方面取得了显著的进步。
3.1钽粉制备
高纯钽粉是制备高性能钽靶材的关键原料,制备钽粉的主要方法有金属钠还原法、均相还原法、氧化钽金属还原法等,其中金属钠还原是目前制备高纯钽粉的主要工艺。李仲香等[26]采用高温脱氢(900~950℃)和低温脱氧(700~800℃)分步进行的工艺控制氧、氢、镁含量及粒度尺寸,通过真空热处理(700~800℃)工艺有效除去脱氧后残余的金属镁和酸洗带入的H、F等杂质。张铭显等[27]从专利角度分析了全球钽粉的制备技术发展趋势,钽粉专利申请数量从2011年开始大幅增加,中国的专利申请比例最大,但欧美企业持有具有高技术门槛和高利润的钽粉制备专利。为了满足新一代半导体的技术需求,钽粉将向着微细、低氧和高纯的方向发展。
3.2钽靶制备工艺
董璞等[28]和李兆博等[29]研究了大尺寸纯坦板的制备工艺,通过多次换向轧制、控制道次加工率、沿板材对角线方向轧制预补偿等措施,制备出板形规矩、利用率高的大规格钽板材。刘施峰等[30]通过锻造电子束熔炼法制备钽锭,以破碎初始钽锭中粗大的柱状晶,切片后经过退火热处理和轧制(每道次旋转135°),再经完全再结晶退火,成品晶粒平均尺寸较为细小,织构均匀,随机取向晶粒含量较高。刘施峰等[31]还公开了一种组织和织构均匀的钽溅射靶材轧制方法,通过对钽板采用多道次交叉轧制,每道次完成后旋转90°,并将钽板的两个轧制面互换,制备出的高纯钽溅射靶材组织、织构分布更为均匀[31]。
3.3钽靶织构控制
织构能够明显影响钽靶材性能,溅射钽靶材需要织构均匀分布,以获得均匀分布的溅射薄膜。轧制变形和再结晶退火是改变晶体材料各向异性的主要手段[32],轧制变形影响滑移系的激活和晶粒的转动状态,形成不同取向织构,再结晶退火则使特定取向的晶粒优先形核并快速长大,形成取向均匀分布的再结晶织构。谢盼平等[33]通过轧制电子束熔炼后的高纯钽锭研究钽板织构与压下量和退火温度的关系。结果表明,850℃退火的板材中存在由{100}<110>组分和γ织构所构成的织构梯度;1000℃退火后,织构组分({100}<110>组分和γ织构)没有明显变化,但强度有提高;1150℃退火使得表面{100}<110>织构衍生出新的{112}<110>组分;经过1300℃高温退火后,钽板γ纤维织构出现{111}<112>取向择优生长。陈明等[34]和毛宇成等[35]发现随着交叉轧制变形量的增加,高纯钽板{111}<uvw>和{100}<uvw>晶粒取向分裂程度增加,且{111}取向分裂程度高于{100}取向。当变形量达到87%时,表面和中心的{100}<uvw>和{111}<uvw>取向晶粒均为长条状,厚度方向织构梯度减弱。柳亚辉等[36]研究了钽板再结晶初、中期与取向相关的晶粒生长速率。结果发现,{111}<uvw>(<111>//ND(法向))晶粒具有生长优势,初始阶段生长速率约为同期{001}<uvw>(<100>//ND)晶粒的1.6倍。
祝佳林等[37]研究了大变形率轧制钽板退火显微组织的演变规律。结果发现,中心区域的变形组织率先形核且由大角度晶界形核机制主导,近表面区域的形核则由亚晶形核机制起主要作用。中心区域比近表面区域表现出更快的再结晶动力学,变形钽板中心区域的{111}<uvw>织构强度高,晶粒内部分裂严重较早发生再结晶;近表面区域{100}<uvw>织构晶粒内部分裂程度相对较小,回复孕育期较长,由此导致再结晶组织和织构沿厚度方向上产生梯度效应。祝佳林等[38]研究表明,低温预退火后再进行高温退火,钽靶表面和中心的再结晶晶粒尺寸最为均匀细小。低温预退火的再结晶机制是亚晶形核,预退火时间增长时,基体内部出现较多的{100}取向晶粒,弱化了高温退火{111}再结晶织构的强度,促进了随机织构的产生。如图6所示,通过低温预热处理和高温再结晶退火处理发现,随着预回复温度的升高,亚晶数目逐渐增加,{111}(111//ND(板法向))和{100}(100//ND)取向晶粒的比值逐渐降低,再结晶晶粒尺寸不断减小并趋近等轴状。低温预热处理使得亚晶形核成为钽再结晶的主导形核机制,释放了部分储存能,降低了再结晶驱动力和晶粒长大速率[39-40]。
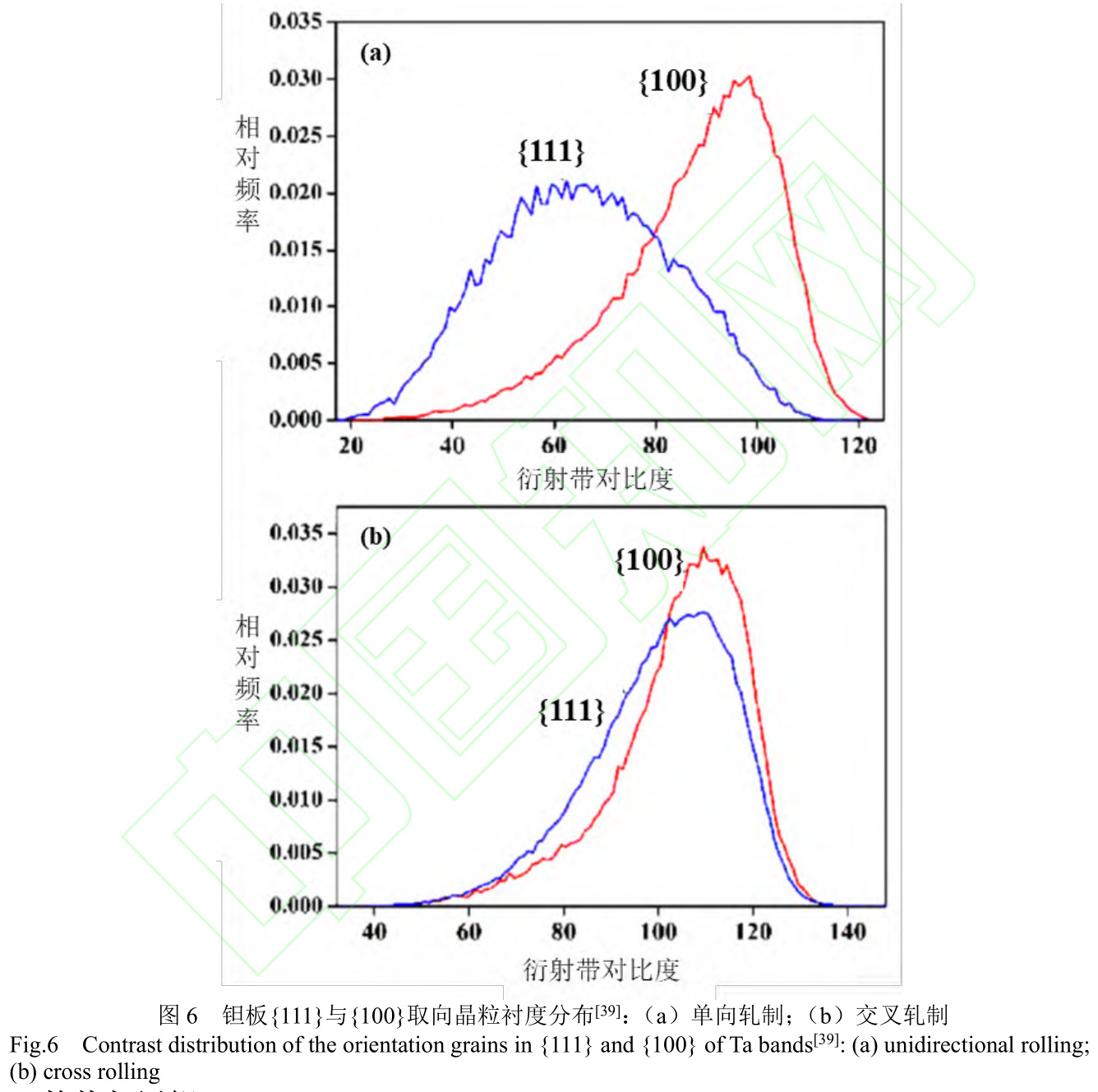
4、趋势与展望
我国钨、钽资源比较丰富,国内企业在国家政策的牵引下不断发力,在靶材整个产业链上不断创新,取得了较大的进展,钨粉与钽粉的纯度突破99.999%,晶粒细化与织构控制技术不断提升,靶材焊接与精密加工能力显著提高。从宏观产业角度来看,高纯难熔金属靶材产业的发展壮大可以带动我国上游传统有色金属行业结构升级,还可促进下游电子产业的技术进步,并可促进信息显示、太阳能等行业的发展。
随着信息产业的升级和半导体制造技术的不断进步,对高纯难熔金属材料及溅射靶材的需求量越来越大,对靶材纯度、性能控制以及靶材整体品质一致性等方面要求越来越高。为了进一步提升我国难熔金属靶材制备水平与制造能力,建议从以下方面进行改进和提升。
(1)稳定提升材料的高纯制备技术水平,开发高附加值新材料。通过技术提升和工艺创新解决产品批次性质量差异,深入研究纯化机制,开发新工艺、新设备,紧跟国际技术发展开发出满足新一代半导体器件的高端材料。
(2)持续提高材料显微组织的调控能力,突破靶材加工制备技术。通过优化制备方式、变形技术和热处理工艺,实现靶材均匀细晶、织构可控分布,重点突破控温轧制、轧锻结合以及晶粒尺寸和织构调控等关键技术。开发关键生产与加工装备,实现高效稳定生产,提升产品应用性能。
(3)注重产业链协同发展,完善应用评价能力。以行业需求为牵引,联合上游原材料生产单位和下游半导体制造企业,带动周边配套加工单位,上下游紧密合作,横向协同发展,建立靶材原料-工艺-性能-应用一体化发展体系。
参考文献
[1] Writing Group of Advanced Semiconductor Materials and Auxiliary Materials. Strategic study on the development of advanced semiconductor materials and auxiliary materials in China. Strat Study CAE, 2020, 22(5):10
(先进半导体材料及辅助材料编写组. 中国先进半导体材料及辅助材料发展战略研究. 中国工程科学, 2020,22(5): 10)
[2] He J J, Lü B G, Jia Q et al. Development of high-purity metal sputtering targets for integrated circuits. Strat Study CAE, 2023, 25(1): 79
(何金江, 吕保国, 贾倩, 等. 集成电路用高纯金属溅射靶材发展研究. 中国工程科学, 2023, 25(1): 79)
[3] Xu Y T, Guo J M, Wang C J, et al. Research progress on precious metal sputtering target. Mater Mech Eng,2021, 45(8): 8
(许彦亭, 郭俊梅, 王传军, 等. 贵金属溅射靶材的研究进展. 机械工程材料, 2021, 45(8): 8)
[4] He J J, He X, Xiong X D, et al. Research progress on preparation of high-purity metal materials and high-performance sputtering targets for integrated circuits. Adv Mater Ind, 2015(9): 47
(何金江, 贺昕, 熊晓东, 等. 集成电路用高纯金属材料及高性能溅射靶材制备研究进展. 新材料产业,2015(9): 47)
[5] Wang H, Xia M X, Li Y C, et al. Application and preparation technology of refractory metal sputtering target.China Tungsten Ind, 2019, 34(1): 64
(王晖, 夏明星, 李延超, 等. 难熔金属溅射靶材的应用及制备技术. 中国钨业, 2019, 34(1): 64)
[6] Liu W D. Research progress of preparation technology of tungsten sputtering targets for integrated circuits.China Tungsten Ind, 2020, 35(1): 36
(刘文迪. 集成电路用钨溅射靶材制备技术的研究进展. 中国钨业, 2020, 35(1): 36)
[7] Wei X Y. Preparation technology and application of high purity tungsten target for semiconductor. Cement Carb, 2017, 34(5): 353
(魏修宇. 半导体用高纯钨靶材的制备技术与应用. 硬质合金, 2017, 34(5): 353)
[8] Yu Y, Song J P, Bai F, et al. Ultra-high purity tungsten and its applications. Int J Refract Met Hard Mater,2015(2): 5398
[9] Yu Y, Lai Y Z, Zhuang Z G, et al. Preparation Method of Tungsten Titanium Alloy Target Material for Semiconductor and Solar Sputtering Target Material Industry: China Patent, 201110149666X, 2013-01-09
(于洋, 赖亚洲, 庄志刚, 等. 半导体及太阳能溅射靶材行业用钨钛合金靶材的制备方法: 中国专利,201110149666X, 2013-01-09)
[10] Yao L J, Aihara T, Oiwa K, et al. Manufacturing Method of Tungsten-Titanium Alloy Target Blank and Target Material: China Patent, 2011103828227, 2014-03-19
(姚力军, 相原俊夫, 大岩一彦, 等. 钨钛合金靶坯及靶材的制造方法: 中国专利, 2011103828227, 2014-03-19)
[11] Qu X H, Li X Y, Zhang L, et al. Preparation Method of High-Purity Tungsten Titanium Alloy Target Material:China Patent, 2022101149126, 2023-04-25
(曲选辉, 李星宇, 章林, 等. 一种高纯度的钨钛合金靶材的制备方法: 中国专利, 2022101149126, 2023-04-25)
[12] Jin Z L, Lin T, Shao H P, et al. Raw material powder by ball-milling in preparation of W-Ti gasket. Chin JRare Met, 2016, 40(7): 679
(金钟铃, 林涛, 邵慧萍, 等. 球磨对制备钨钛封垫的原料粉末的影响. 稀有金属, 2016, 40(7) :679)
[13] Yang Y H, Li J B, Liu W D, et al. Preparation of high purity WTi alloy by decomposition of TiH 2 at high temperature. Rare Met Mater Eng, 2021, 50(6): 2258
(杨益航, 李剑波, 刘文迪, 等. 氢化钛高温分解制高纯 WTi 合金. 稀有金属材料与工程, 2021, 50(6): 2258)
[14] Guo R M, Dan X G, Hou J T, et al. Effects of pressure way on vacuum hot-press sintering process of W-10Ti% alloy. Hot Working Technol, 2013, 42(10): 120
(郭让民, 淡新国, 侯军涛. 加压方式对钨钛合金真空热压烧结工艺的影响. 热加工工艺, 2013, 42(10): 120)
[15] Cui M P, Wang J S, Ren S, et al. Tungsten Alloy Target Material and Preparation Method Thereof: China Patent, 2011101133083, 2013-01-23
(崔明培, 王家生, 任山, 等. 一种钨合金靶材及其制备方法: 中国专利, 2011101133083, 2013-01-23)
[16] Yang Y H, Wang Q D, Li B Q, et al. High temperature and high pressure preparation and phase characterization of WTi10 alloy. Rare Met Mater Eng, 2021, 50(2): 664
(杨益航, 王启东, 李保强, 等. WTi10 合金的高温高压制备及相特征. 稀有金属材料与工程, 2021, 50(2): 664)
[17] Yao L J, Pan J, Aihara T, et al. A Tungsten-Titanium Tube Target Manufacture Method: China Patent,2015103511569, 2019-05-10
(姚力军, 潘杰, 相原俊夫, 等. 钨钛管靶的制造方法: 中国专利, 2015103511569, 2019-05-10)
[18] Cai X Z, Tong P Y, Zhu L, et al. Tungsten-Titanium Alloy Target Material As Well As Preparation Method and Application Thereof: China Patent, 2021108035367, 2023-08-11
(蔡新志, 童培云, 朱刘, 等. 一种钨钛合金靶材及其制备方法、应用: 中国专利, 2021108035367, 2023-08-11)
[19] Wang G D, Tao H L, Liu G H, et al. A Kind of Rolling Processing Tungsten Titanium Alloy Target Material:China Patent, 2016108445159, 2018-11-23
(王广达, 姚惠龙, 刘国辉, 等. 一种轧制加工钨钛合金靶材的制备方法: 中国专利, 2016108445159, 2018-11-23)
[20] Li B Q, Chen J, Liu W D, et al. Research progress in preparation and application of tungsten silicide films for semiconductor. China Tungsten Ind, 2020, 35(3): 48
(李保强, 陈金, 刘文迪, 等. 半导体用钨硅薄膜的制备技术及应用研究进展. 中国钨业, 2020, 35(3): 48)
[21] Huang Z M, Wang D Z, Wu Z Z, et al. Preparation technology of tungsten silicide alloys used for sputtering target. Powder Metall Technol, 2021, 39(5): 445
(黄志民, 王德志, 吴壮志, 等. 靶材用钨硅合金的制备工艺. 粉末冶金技术, 2021, 39(5): 445)
[22] Zhang L H, Xu G Z, Zhou J A, et al. A Process for Preparing High-Purity Si-W Powder: China Patent,2022102560055, 2023-12-05
(张龙辉, 徐国钻, 周俊安, 等. 一种高纯硅钨粉的制备方法: 中国专利, 2022102560055, 2023-12-05)
[23] Yao L J, Pan J, Bian Y J, et al. Preparation Method of Tungsten-Silicon Target Blank: China Patent,2021111338488, 2023-01-23
(姚力军, 潘杰, 边逸军, 等. 一种钨硅靶坯的制备方法: 中国专利, 2021111338488, 2023-01-23)
[24] Li L L, Ding Z C, Qu P, et al. The Preparation Method of High-Purity Low Oxygen Tungsten-Silicon Alloy Target Material: China Patent, 2021102956062, 2023-04-18
(李利利, 丁照崇, 曲鹏, 等. 一种高纯低氧钨硅合金靶材的制备方法: 中国专利,2021102956062, 2023-04-18
[25] Cheng S L, Ma G C, Ou H L, et al. The Invention Relates to a Preparation Method of a Tungsten-Silicon Alloy Target Material: China Patent, 2021115194758, 2023-09-05
(程少磊, 马国成, 欧海玲, 等. 一种钨硅合金靶材的制备方法: 中国专利, 2021115194758, 2023-09-05)
[26] Li Z X, Yang G Q, Chen X Q, et al. Study on production process of high pure tantalum powder for tantalum target. Dev Appl Mater, 2017, 32(3): 67
(李仲香, 杨国启, 陈学清, 等. 溅射钽靶材用高纯钽粉工艺研究. 材料开发与应用, 2017, 32(3): 67)
[27] Zhang M X, Zhu F, Zhang G X, et al. Analysis on current status and trend of tantalum powder preparation technology based on patents. Powder Metall Ind, 2023, 33(6): 140
(张铭显, 朱芳, 张国祥, 等. 基于专利分析的钽粉制备技术现状研究与趋势分析. 粉末冶金工业, 2023, 33(6):140)
[28] Dong P, Xue J J, Zhou L H, et al. Trial-manufacture of large scale pure tantalum plate. Hot Working Technol,2016, 45(18): 93
(董璞, 薛晶晶, 周龙海, 等. 大规格纯钽板材的试制. 热加工工艺, 2016, 45(18): 93)
[29] Li Z B, Du L H, Wang K, et al. The research of large size tantalum sheets’ rolling technology. Dev Appl Mater,2020, 35(5): 59
(李兆博, 杜领会, 汪凯, 等. 大规格钽板材轧制工艺研究. 材料开发与应用, 2020, 35(5): 59)
[30] Liu S F, Long D D, Zhu J L, et al. Processing Method for Improving the Uniformity of Microstructure of Thick Tantalum Target: China Patent, 2021100487440, 2021-06-01
(刘施峰, 龙豆豆, 祝佳林, 等. 一种提高厚靶材用钽板微观组织均匀性的加工方法: 中国专利,2021100487440, 2021-06-01)
[31] Liu S F, Lin N, Liu Y H, et al. Tantalum Plate Rolling Method for Sputtering Target Material for Obtaining Uniform Tissue and Texture: China Patent, 2018102053497, 2020-09-08
(刘施峰, 林男, 柳亚辉, 等. 一种获得均匀组织和织构的溅射靶材用钽板轧制方法: 中国专利,2018102053497, 2020-09-08)
[32] Pan W G, Chen W Y, Wu L E. Progress in rolling and recrystallization on textures of tantalum. Mater Rev,2016, 30(21): 150
(潘文高, 陈炜晔, 吴澜尔. 钽材轧制和再结晶织构演变研究进展. 材料导报, 2016, 30(21): 150)
[33] Xie P P, Yuan S C, Hu L K, et al. Rolling and annealing texture of high-purity tantalum plate. Min Metall Eng,2019, 39(6): 129
(谢盼平, 袁思成, 胡立坤, 等. 高纯钽板的轧制与退火织构. 矿冶工程, 2019, 39(6): 129)
[34] Chen M, Zhu X G, Wang X P, et al. Study on tantalum grain refinement process and microstructure, texture.Hot Working Technol, 2010, 39(8): 26
(陈明, 朱晓光, 王欣平, 等. Ta 晶粒细化工艺及组织、织构的研究. 热加工工艺, 2010, 39(8): 26)
[35] Mao Y C, Liu S F, Fan H Y, et al. Evolution of texture gradient and microstructure of high purity tantalum in clock-rolling process. J Chin Electron Microsc Soc, 2017, 36(1): 7
(毛宇成, 刘施峰, 范海洋, 等. 高纯钽交叉轧制过程中微观结构和织构梯度的演变. 电子显微学报, 2017,36(1): 7)
[36] Liu Y H, Liu S F, Fan H Y, et al. Study on the orientation-dependent grain growth of high purity tantalum. JChin Electron Microsc Soc, 2016, 35(1): 17
(柳亚辉, 刘施峰, 范海洋, 等. 高纯钽板中晶粒生长的取向相关性研究. 电子显微学报, 2016, 35(1): 17)
[37] Zhu J L, Liu S F, Liu Y H, et al. Gradient of microstructure and texture evolution of cold rolled high purity tantalum plate during annealing process. Mater Rev, 2018, 32(20): 3595
(祝佳林, 刘施峰, 柳亚辉, 等. 冷轧高纯钽板退火过程中微观组织及织构演变的梯度效应. 材料导报, 2018,32(20): 3595)
[38] Zhu J L, Deng C, Liu Y H, et al. The effect of pre-annealing on recrystallization behavior of purity tantalum.J Chin Electron Microsc Soc, 2018, 37(6): 607
(祝佳林, 邓超, 柳亚辉, 等. 预退火对纯钽再结晶行为的影响. 电子显微学报, 2018, 37(6): 607)
[39] Zhu J L, Mao Y C, Liu S F, Stored energy evolution of high-purity tantalum during annealing and its effect on recrystallization behavior. Chin J Nonferrous Met, 2019, 29(1): 54
(祝佳林, 毛宇成, 刘施峰, 等. 高纯钽退火过程中储存能演变及其对再结晶行为的影响. 中国有色金属学报,2019, 29(1): 5)
[40] Zhu J L, Deng C, Liu Y H, et al. The stored energy evolution and recrystallization behavior of tantalum plate during annealing. Mater Rev, 2019, 33(4): 654
(祝佳林, 邓超, 柳亚辉, 等. 钽板退火过程中的储存能演变与再结晶行为. 材料导报, 2019, 33(4): 654)
相关链接